Фирма-изготовитель: Лаборатория плазменной эмиссионной электроники ИСЭ СО РАН
Страна происхождения: Россия
Год выпуска: 2012
Назначение
Ионно-плазменная очистка, активация поверхности из-делий, формирование азотированного подслоя, вакуумно-дуговое плазменно-ассистированное напыление функцио-нальных покрытий. Виды покрытий: TiN, CrN, ZrN, TiAlN, AlCrN, AlMgB14, AlTiCrNbMo, (AlTiCrNbMo)N и др., многослойные и градиентные покрытия.
Основные характеристики
| Размеры вакуумной камеры | 650×650×770 мм |
| Давление | 0.01–1 Па |
| Скорость нанесения покрытий | до 6 мкм/ч |
| Размеры установки | 2500×2500×2000 мм |
| Потребляемая мощность | до 50 кВт |
| Расход воды для охлаждения | 2 м3/ч |
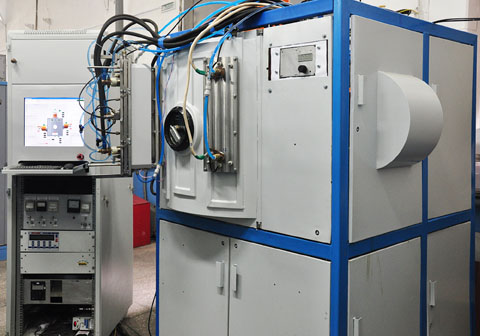
Возможности и особенности
- возможность работы на смеси двух газов;
- возможность проведения комплексных процессов обработки, включающих ионную очистку, диффузионное насыщение и напыление покрытий
- возможность одновременного создания газовой и металлической плазмы в одном вакуумном объеме;
- широкий диапазон параметров;
- независимая регулировка основных параметров;
- нанесение твердых и сверхтвердых покрытий с регулируемой in situ стехиометрией;
- повышение коррозионной стойкости и износостойкости поверхности изделий;
- возможность одновременного или поочередного использования двух материалов катода;
- возможность использования композиционных катодов;
- обработка изделий сложной формы;
- глубина обработки до 500 мкм;
- нет специальных требований по размещению установки (низкая величина ускоряющего напряжения, не требуется дополнительная радиационная защита);
- использование манипулятора позволяет обрабатывать образцы с большой площадью поверхности или партию мелкоразмерных образцов или изделий;
- увеличенная область однородной обработки изделий;
- автоматизация управления вакуумной системой;
- автоматизированная стабилизация рабочего давления;
- автоматизированная стабилизация состава газовой смеси;
- автоматизация управления параметрами технологического цикла;
- возможность создания новых технологических процессов по технологической карте;
- возможность автоматического проведения заданных технологических процессов.
Контактная информация
Институт сильноточной электроники СО РАН, (ИСЭ СО РАН)
634055, г. Томск, пр. Академический 2/3
Заведующий лабораторией
плазменной эмиссионной электроники
АХМАДЕЕВ Юрий Халяфович
ahmadeev@opee.hcei.tsc.ru
+8 3822 491713
+7 923 408 6284










